




PowerDC能对IC封装提供快速准确的直流分析和电热协同分析,是一个能对封装设计进行电热协同仿真分析的工具,充分了考虑电和热之间的相互影响,不但包含器件的发热,还考虑了板上走线产生的焦耳热。PowerDC提供了一个详细的工作流程来发现封装设计中隐含的直流压降问题、电流密度问题和热可靠性问题。这些问题可能导致系统故障并带来额外的产品成本。PowerDC能支持多Die堆叠的封装设计,能进行复杂设计的DRC检查,可以得到Die、过孔和封装等各组件的温度,还可以得到JEDEC定义的各种封装热参数模型。
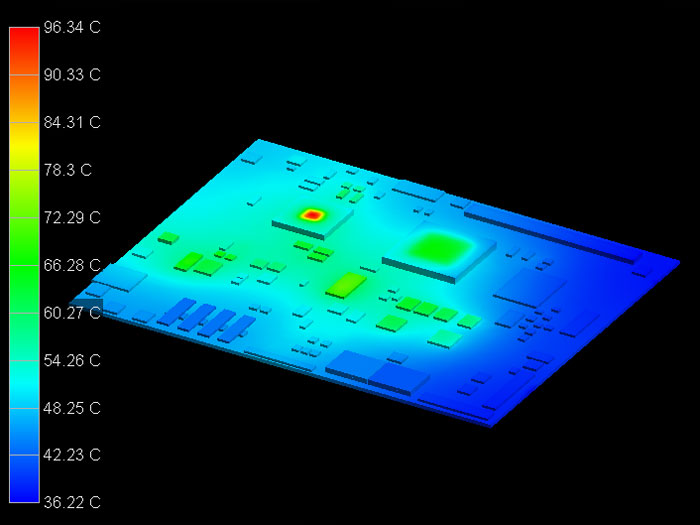
1) 全面支持各种封装结构,如各种Flip-chip和Wirebond
2) 精确分析封装各部分的电压分布、平面电流分布、过孔电流分布和功耗分布
3) 能提取任意位置间的电阻网络,并分析芯片各管脚的有效性
4) 内置的仿真规则管理支持复杂设计的DRC检查,并映射到设计文件中
5) 是一个针对封装设计进行电热协同仿真的工具,能充分考虑电热之间的相互影响;
6) 不但包含器件的发热,还考虑了板上走线产生的焦耳热
7) 可以得到JEDEC定义的封装设计的各种热参数以及热模型
8) 可以得到包括Die, 过孔和封装在内的各组件的温度